过去数十年来,摩尔定律犹如法则一般引领了半导体行业的发展,半导体制程持续升级,然而,当先进制程技术已走到5nm、3nm,甚至IBM已经发布了全球首个2nm的芯片制造技术,晶体管大小正不断逼近原子的物理体积极限。
当制程物理体积到达极限之后,无法再继续进步,那就意味着靠制程推动的摩尔定律时代的终结,但与此同时,5G、自动驾驶、人工智能、物联网等应用正快速兴起,对芯片的性能要求更高,半导体行业下一个十年方向在哪里?
2021年6月,AMD宣布携手台积电(TSM.US),开发出了3D Chiplet技术,并且将于2021年年底量产相应芯片。AMD总裁兼CEO苏姿丰表示,该封装技术具有突破性,采用先进的hybrid bond技术,将AMD的Chiplet架构与3D堆栈结合,提供比2D Chiplet高出超过200倍的互连密度,以及比现有3D封装解决方案高出15倍的密度。
作为Fabless和Foundry两大领域最杰出的代表之一,这两家企业对未来半导体行业的发展方向做出的判断以及业内的普遍共识便是:先进封装技术的发展。
封装测试是将生产出来的合格晶圆进行切割、焊线、塑封、切割成型,使芯片电路与外部器件实现电气连接,并为芯片提供机械物理保护,并利用集成电路设计企业提供的测试工具,对封装完毕的芯片进行功能和性能测试。
相较于传统封装,先进封装作为制造的后道工序,正不断前移,持续压缩芯片体积、提高加工效率、提高设计效率,并减少设计成本。此外,传统封装的封装效率(裸芯面积/基板面积)较低,存在很大改良的空间。先进封装技术通过以点代线的方式实现电气互联,实现更高密度的集成,大大减小了对面积的浪费。
什么是先进封装?
先进封装技术主要包括Flip-Chip(倒装)、Wafer Level Packaging(WLP,晶圆级封装)、2.5D封装和3D封装以及系统级封装(SiP)等,SiP技术奠定了先进封装时代的开局,2D集成技术,如Wafer Level Packaging(WLP,晶圆级封装)、Flip-Chip(倒装)以及3D封装技术、Through Silicon Via(TSV,硅通孔)等技术的出现进一步缩小芯片间的连接距离,提高元器件的反应速度,未来将继续推进着先进封装的脚步。
目前主要先进封装工艺的介绍及主要作用:
先进封装时代,封测设备作用凸显
- 半导体设备投资占产业资本支出60%以上,极易形成垄断,对于投资至关重要
设备投资占半导体产业资本支出的60%以上,制造、封装、测试设备的价值量大,直接影响着半导体生产的技术水平与良率。
根据CIC灼识咨询统计数据,2020年,全球半导体设备市场达到724亿美元,预计到2025年将达到1,024亿美元,复合年增长率为7.2%。CIC灼识咨询预测,全球封测设备在半导体设备中的占比将从2020年的16.7%提升到2025年的18.6%,市场体量将达到约190亿美金。
在封装流程中,可将其按步骤分为贴片、引线、划片与测试、切筋与塑封。其中,在先进封装过程中贴片机是最关键、最核心的设备。
全球先进封装设备头部玩家梳理
Besi
Besi于1995在荷兰成立,是面向全球半导体和电子行业的半导体组装设备的领先供应商,为终端用户市场开发领先的组装工艺和设备,用于引线框架、基板和晶圆级封装应用。公司产品线涵盖封装线上的各类设备,其中包括18种贴片机设备。主要覆盖电子、移动互联网、汽车、工业、LED和太阳能等行业,客户主要是领先的半导体制造商、组装分包商以及电子和工业公司,其中包括ASE、Amkor、富士康、Greatek等多家大型半导体企业。
ASM
ASM Pacific于1975年在香港成立,总部位于新加坡,自1989年起在香港联交所上市,是全球首个为半导体封装及电子产品生产的所有工艺步骤提供技术和解决方案的设备制造商。ASM囊括晶圆制造和封装测试过程中的大部分设备的生产,共有贴片设备25种,焊线机12种,塑封设备5种,切筋设备2种以及6种测试设备。主要覆盖CIS、计算机领域、自动化电子设备、LED、移动通讯等行业。
Capcon
Capcon Limited(华封科技有限公司),于2014年在香港成立,研发中心和生产总部位于新加坡,是聚焦先进封装设备领域的高端装备制造商。公司产品对先进封装贴片工艺实现了全面覆盖,包括FOWLP (Face Up/Down)、POP、MCM、EMCP、Stack Die、SiP、2.5D/3D、FCCSP、FCBGA等公司定位在半导体先进封装领域,针对半导体后道工序提供全新一代先进封装贴片设备,如倒装贴片机、晶圆级贴片机、POP封装机、层叠贴片机、面板级贴片机、多晶片贴片机等。主要服务客户有台积电、日月光、矽品、长电科技、通富微电、DeeTee等;2020年出货量在15台,2021年预计出货量在35台左右。
Kulicke & Soffa
Kulicke & Soffa于1956年成立,总部位于新加坡,是全球领先的半导体封装和电子装配解决方案企业。近年来,K&S通过战略性收购和自主研发,增加了先进封装、电子装配、楔焊机等产品。主要覆盖客户行业为汽车、消费电子、通讯、计算机和工业等。
据CIC灼识咨询统计,目前先进封装贴片设备,以出货量或收入计,市场中Besi、Capcon和ASM几乎占据市场绝大多数体量。


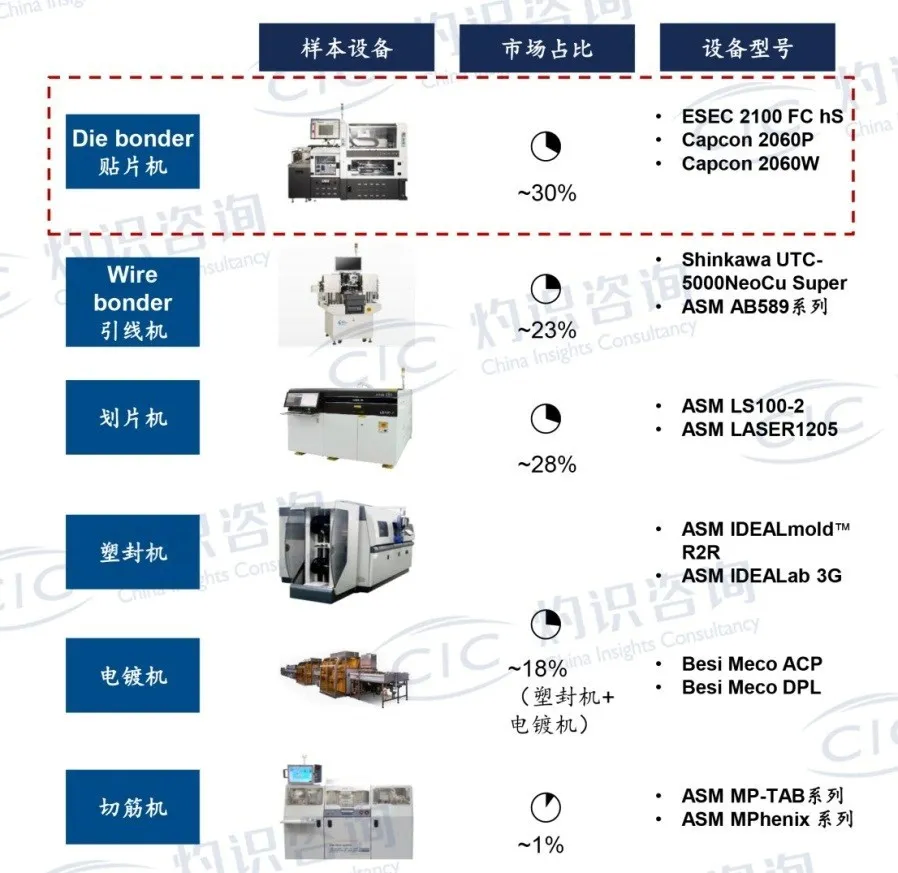
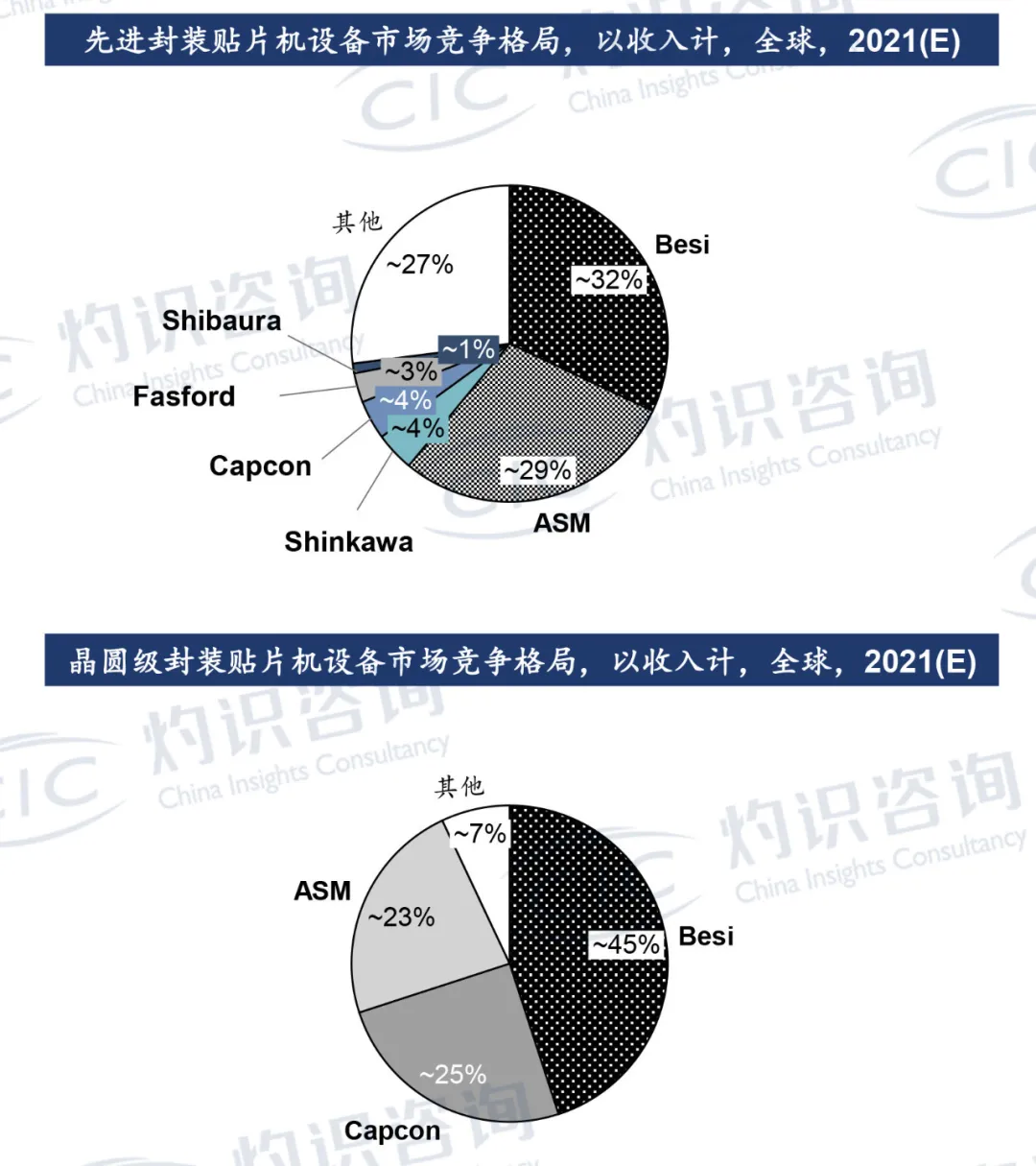
Comments